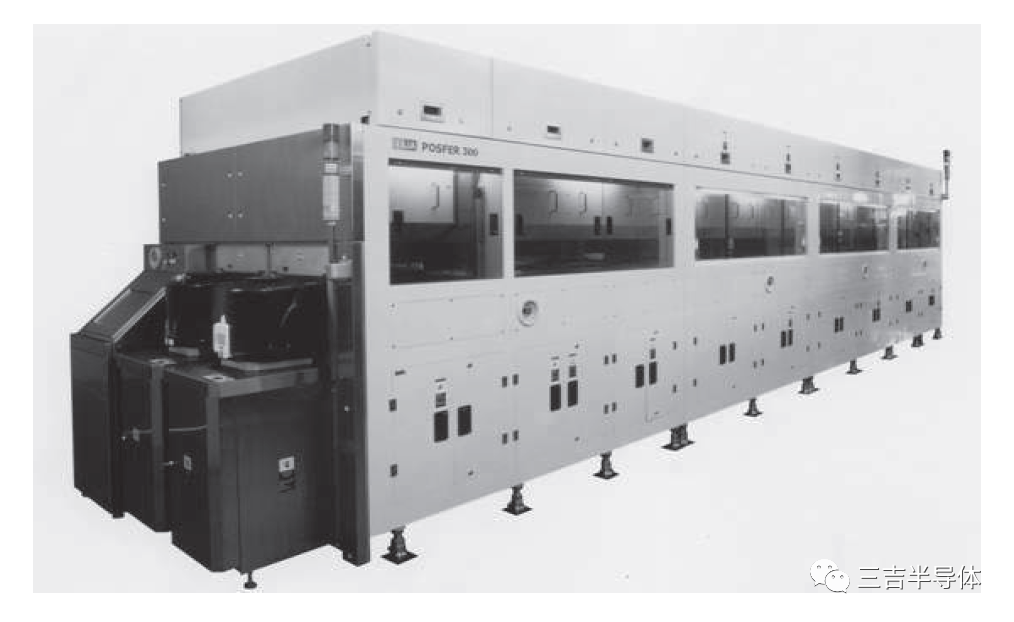
1.前言
到目前为止,半导体晶圆已经按照摩尔定律实现了高度集成化和微型化。而且,半导体封装方面,也从传统的平面二维(2D)安装,逐渐过渡到堆叠芯片的立体三维(3D)安装。与此同时,待电镀的电极尺寸也从引线键合的约100μm减小到3D安装凸点键合的Φ2-10μm,尺寸减少了至少一个数量级,微小部分的镀膜析出性能变得愈发重要。此外,为了提高生产效率而逐渐增大的晶片尺寸,使得实现镀膜厚度面内均匀性方面的技术难度变得更大。
近年来,对于使用了诸如图像传感器、高频滤波器和TSV(硅通孔)的存储器件之类的晶片中的Via(孔)的电镀需求不断增长。该Via的直径也越来越细小,镀液对Via底部的液体循环性能和润湿性对镀膜析出性能有很大的影响。
另一方面,从建浴后开始随着电镀过程的进行,金属浓度会减小,添加剂会消耗,而副产物和杂质的浓度会增加,镀液中各成分的平衡会经常变化,电镀过程的控制技术变得尤为重要。
基于此,本文将首先介绍晶圆电镀设备的类型和结构,然后从电镀设备的角度,介绍一些示例以说明电镀工艺技术的改进是如何响应市场需求的。然后,基于晶圆技术的最新趋势,描述今后的挑战。
2.晶圆电镀设备
2.1 类型和主要特点
晶圆电镀设备(电解电镀)大致可分为两种:一种是将晶圆垂直放入电镀槽的DIP法,另一种是将晶圆水平(横向)放入电镀槽的CUP法。
在DIP法中,晶圆固定在夹具中,夹具垂直放入电镀槽中,虽然晶圆附着和脱离的频率较低,但搅拌方向固定,难以保证镀层厚度的面内均匀性,且存在大量液体被带出到下一个槽的缺点。
另一方面,CUP法是将晶圆水平直接固定在CUP型槽中的电镀方法,在高速搅拌和高速液流性能方面表现优异,可以实现高电流密度的高速电镀。而由于采用水平方式,设备的安装面积往往较大,这也是一个缺点。表1显示了两者的特点比较。

如上所述,今后镀层厚度的平面内均匀性将变得更加重要,本章将在下一节详细介绍具有高速搅拌可控性的CUP法。
2.2CUP型晶圆电镀设备结构
CUP法分为面朝上结构和面朝下结构,前者是将晶圆固定在CUP型镀槽的底部,镀面朝上;后者是将晶圆固定在镀槽的顶部,镀面朝下。
面朝上结构中实现高速液体流动的方法,如图1所示,存在这样一种结构,其中液体从晶片的上表面的一侧沿一个方向高速地循环。在这种结构中,由于液体流动在一个方向上是固定的,所以其缺点在于该趋势容易影响镀膜厚度分布。

图1 面朝上型CUP结构
与之相比,面朝下结构的优点是液体不易泄漏,因为晶圆位于电镀槽的上部,而且由于可以操作晶圆的背面,运输方便,并且颗粒附着在电镀表面的风险也低。图2展示了面朝下型的CUP结构,图3展示了使用CUP的自动电镀设备的照片。

图2 面朝下型CUP结构

图3 CUP型全自动电镀设备全貌
如图2所示,面朝下型CUP由从底部喷射电镀液的喷嘴(Nozzle)、阳极(Anode)、使阴极侧电位分布均衡(修正外周厚度)的遮挡板、使晶圆外周即阴极侧通电的环形阴极触点(Ring Cathode)等构成。虽然图中没有显示,但为了抑制镀液中添加剂的消耗,可以在阳极上方安装研钵状的隔膜以将阳极和阴极分开。此外,在其上方安装有用于搅拌镀液的旋转搅拌叶片(Stirrer)。
如果布置多个这种搅拌叶片,并且每个搅拌叶片一边自转一边绕轨道公转,则槽中液体的流动方向总是不断改变,因此与普通的桨式搅拌相比,金属离子在平面中的分布更加均匀,在提高镀层厚度的面内均匀性方面是更有效的。
3.电镀工艺技术
如上所述,市场上有关电镀工艺技术改进的需求是镀膜厚度的面内均匀性、镀层在微小图形和Via上的析出性等,宜从镀液和电镀设备两方面进行改进。接下来,我们从设备方面介绍一下满足这些需求的方法。
3.1 晶圆镀膜厚度的面内均匀性
采用CUP型电镀系统电镀时,影响面内均匀性的因素主要有两个,一个是与电流电位分布有关,另一个是与液流的流速分布有关。
电流电位分布因素可采用有限要素法等分析方法进行数值模拟,如图4所示。一般来说,当阳极(Anode)和阴极(晶片)以相同的面积和形状彼此面对地排列时,外围部分的电流电位变高,晶片外围部分的镀层厚度也趋于变厚。与这种电流电位分布有关的因素包括阳极和阴极的尺寸比(阴极是晶圆,所以可变化的是阳极)、阳极和阴极之间的距离(两极之间的距离)以及遮挡板的安装。作为纠正上述外围部分趋于变厚的措施,如果将阳极的直径做得更小,两极之间的距离做得更近,可以看到改善趋势。但一定要注意,因为如果阳极做得太小,阳极侧的电流密度就会增大,从而影响浴槽负载,而如果做得太近,中心部分则可能会变得太厚。另外,也可以通过在阴极附近添加一个环形的遮挡板来纠正周边变厚的趋势。

图4 模拟分析
流速分布因素包括泵循环流速和搅拌,这对于维持面内均匀性和在阴极附近不断均匀地提供离子非常重要。特别是当需要在高电流密度或高温下增加析出速率时,这个因素尤其重要。此外,由于搅拌器位于阳极与喷嘴和阴极之间,所以来自喷嘴的液体的流速和方向发生变化,这可能会影响遮挡效果的好坏。在这种情况下,必须优化搅拌器的形状和尺寸以及阳极和遮挡板的形状和尺寸。
另一方面,除了上述两个因素之外,面内均匀性还受到晶片规格的很大影响。例如,电镀表面的开口率和图案尺寸或分布疏密程度等晶片规格也有很大影响。因此,需要使用电镀设备进行电镀测试并进行实机验证。晶圆电镀设备量产机的电镀槽尺寸通常约为50至100 L,但如果采用研发用的电镀设备,其电镀槽结构与量产机相同,如图5所示,槽的大小为10L,可以减少实际机器验证过程中电镀液的成本,并减少使用后的废液量。

3.2 精细图案和Via的电镀析出性
对于小孔径的光刻胶(PR)精细图案的电镀和高深宽比的TSV(硅通孔)的电镀,这些小孔径和Via底部的渗漏性可能较差,因此对电镀进行预处理对镀层的沉积性、空隙率和附着力有很大影响。传统的预处理方法一般为浸泡法或单流体喷嘴喷淋法,但由于精细图案或TSV的规格情况,润湿性有时可能不够。
为了解决这个问题,采用图6所示的旋转清洁设备,将预处理液与气体混合后,从双流体喷嘴将微小液滴(雾状)喷到晶圆上,使预处理液更容易渗透到精细图案和TSV的Via底部,可提高润湿性。但是,由于处理液和气体是混合的,因此,与使用单流体喷嘴的传统喷雾法相比,喷雾液的用量较少。特别是,喷嘴与晶片之间的距离越长,晶片表面内的喷液量可能越不均匀。反之,如果缩短与晶圆的距离,喷雾面积就会减小,因此需要通过放慢喷嘴移动和晶圆旋转速度或增加频率来优化和延长处理时间。

图6 使用双流体喷嘴的晶圆清洗设备示例
另一种方法是在预处理液与晶圆接触之前进行脱气,以消除在TSV等凹陷区域形成气泡的可能性。此方法也适用于面朝下结构的晶圆电镀设备。此外,对于含有易氧化成分的电镀溶液也很有效,因为脱气可以去除溶液中的溶解氧。作为另一种脱气方法,通过降低CUP槽中的压力也可以达到同样的效果。
3.3工艺管理技术
除了在阴极上发生电镀析出反应外,由于电镀液中副产物的增加,电镀液状态也会不断变化,因此从维持运行中的电镀质量和液体寿命的角度来看,电镀工艺管理技术非常重要。因此,将自动在线分析并根据分析值自动补充适量添加剂的系统应用于电镀装置有可能是有效的。
但是,有些问题仅靠分析补充是无法避免的。例如,在硫酸铜电镀中溶解阳极上形成的黑膜可能会脱落,或者添加剂可能会分解。对策方面,有一种方法是做一个由隔膜隔开的结构,将供给到阳极侧镀槽内的液体和从液体供给部位供给至晶片(阴极)的液体隔开。另外,Sn电镀和AuSn合金电镀时有着Sn2+很容易被氧化和消耗,电镀液中Sn2+的浓度很容易改变的问题。对策方面,与前面所述一样,用离子交换膜将阳极室和阴极室隔开,并安装用来去除沉淀的沉淀槽、过滤设备或活性炭处理槽等。
另一方面,还有一种电镀线,通过再生电镀液并将其返回电镀槽中,以提高镀液管理的效率。电镀液在运行过程中会随着杂质浓度和比重的增加而老化,但从老化的Au镀液中去除杂质,仅提取Au盐,然后将其送回镀槽的机制也可以。此外,还可以从电镀槽后面的回收(Drag-out)槽或水洗槽中进行浓缩回收,再返回电镀槽。
4.今后的挑战
未来晶圆电镀设备业务的发展将受到半导体封装技术趋势的极大影响。
近年来,预计将从布线图案置于芯片内部的扇入型(Fan-in)晶圆级CSP(芯片尺寸封装)向布线图案置于芯片外部的扇出型(Fan-out)转变。这是因为扇出型可以实现更小的芯片尺寸、搭载多终端和不同类型的多芯片,以及有着更高的封装设计自由度。从封装制造工艺的角度考虑,扇入型工艺是在晶圆级,而扇出型工艺可以是在面板级。换句话说,这意味着未来会有一些产品从晶圆电镀转为面板电镀。
另外,用于功率器件和高频器件的晶圆有望从传统的Si和GaAs转向SiC和GaN,而且会像Si上的GaN一样,将由多种类型的衬底而非单个衬底组成。这种电镀设备上面,除了低冲击力的运输系统外,还需要设计电镀用的电流和防止漏液的密封结构。
此外,在电镀工艺方面,由于对导电性、耐热性、耐蚀性、低温工艺的需求不断增加,预计从单一金属电镀到各种合金电镀以及使用碳纳米管(CNT)和纳米金刚石的复合电镀等将有所增加。对于这些方面,上文3.3所述的工艺管理技术将变得越来越重要。
5.结语
本文介绍了电解电镀的晶圆电镀设备,但预计今后在LSI等逻辑器件上,无电解电镀的应用将逐步增加。无电解电镀不需要从种子层形成到光刻工艺再到种子层刻蚀等一系列工序,与电解电镀工艺相比,其优点是设备资金投入和工艺成本可以大大降低。但相反地,与电解电镀相比,其电镀工艺管理更复杂、更困难。
未来,我们希望进一步探索电解和无电解电镀解决方案的可能性,包括有市场增长预期的物联网(IoT)和显示器相关的趋势。
产品信息详见公司官网 www.cycad-century.com,联系电话:010-56380018
上一信息:怎样才能更好地在晶圆上进行电镀
下一信息:SMT平行封焊原理是怎样的
Copyright © 2003-2036 北京三吉世纪科技有限公司Beijing CYCAD Century Science and Technology Co.,Ltd.版权所有 京ICP备14025030号-1 北京市开发区分局11030102011349